快恢复二极管的结终端技术
作者:海飞乐技术 时间:2018-05-23 18:26
目前行业内主要的结终端技术包括:场限环结构、场板结构、结终端扩展、横向变掺杂、半绝缘多晶硅薄膜表面钝化技术等。
1. 场限环(Floating Field Ring)技术
场限环结构,扩散形成PN主结的同时,在其周围做同样掺杂的一个或多个环,场限环与主结及其它电极并无电接触,因此又称为浮空场限环。如图1所示。场限环技术使目前功率器件中普遍采用的一种终端技术。它的工艺非常简单,可以与主结一起扩散形成,无须增加任何工艺步骤。
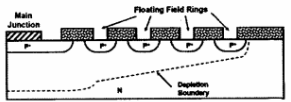
图1 场限环结构原理图
当主结上反向偏压增加至导致第一环和主结间的穿通时,耗尽区从主结扩展到第一环,于是主结上的最大电场受到限制。继续增加主结上的反向偏压,则耗尽区由第一环结向N区扩展直至第二环为止,如此类推,最后在最外环的柱面结或球面结上出现雪崩击穿。于是,我们就达到了利用浮空P+环来抑制主结的边缘曲率效应引起的电场集中,从而提高了器件的边缘击穿电压。扩散保护环的击穿电压的分析比较复杂,它与许多因素有关,例如环间距、环宽、掺杂浓度及梯度、结深和表面电荷等。
场限环技术仿真试验结构如图2所示。图2(a)展示了场限环单环和三环在反向偏置时,耗尽区的分布情况图2 (b)比较了两种情况下最大电场强度的变化:图2 (c)比较了两种情况下击穿电压的变化。通过仿真实验比较,可知多场限环多场板终端技术可以有效提高器件的耐压性,同时降低最大电场强度,提高器件的可靠性。
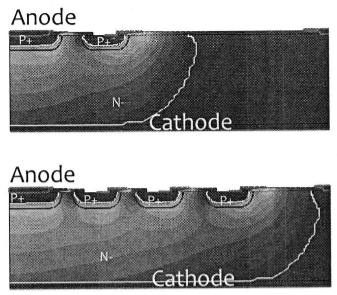
(a)场限环单环与三环的反偏耗尽比较

(b)最大电场E=2.7e5V/cm(单环)与E=2.5e5V/cm(三环)
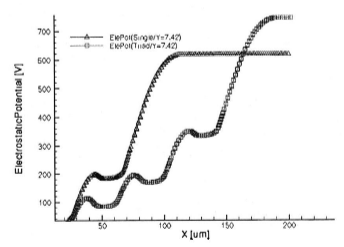
(c)击穿电压BV=610V(单环)与BV=760(三环)
图2 场限环仿真结构比较(a)耗尽区比较 (b)最大电场强度比较 (c)击穿电压比较
场板技术是把金属条或者低阻多晶硅条扩展到结外N区的上方,当器件的主结上加反向偏压时,由于场板相对于N区为负电位,抵消了SiO2层中的正电荷对N区表面的影响,并且排斥表面电子,使表面耗尽区扩展得比体内更宽,因而改善了表面击穿特性,提高了边缘击穿电压,如图3所示。
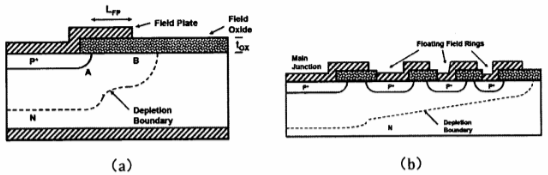
图3 场板技术
(a)场板结构示意图 (b)场板+场限环结构示意图
在场板技术中,场板下的氧化层对击穿电压影响很大。研究表明,当氧化层厚度较小时,击穿发生在场板边缘而当氧化层较厚时,击穿将发生在结附近。因此,在结附近,如果氧化层厚度越薄,场板降低电场强度和雪崩倍增的作用就越大,就能更有效的减小曲率电场,所以在结附近,氧化层的厚度应尽可能薄一些;在场板边缘,当氧化层较博时,氧化层上的电压降相对于总的击穿电压值可以忽略,由于场板边缘的电场集中(类似于柱面结),击穿先于平面结发生在场板边缘当场板边缘的氧化层较厚时,电力线聚集在氧化层内而不是N区内,氧化层上压降很大,减少了N区内的压降,因此在场板边缘的氧化层厚度应尽可能厚一些。
(a)场板结构示意图 (b)场板+场限环结构示意图
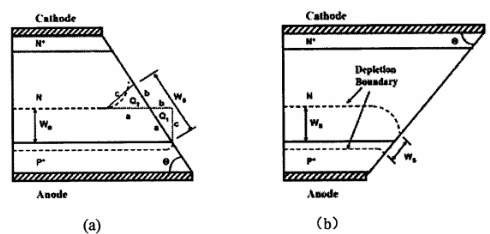
图4 结终端斜面技术
(a)正斜面结构示意图 (b)负斜面结构示意图
(a)正斜面结构示意图 (b)负斜面结构示意图
3. 结终端斜面化和腐蚀
斜表面(Bevelled Sufface)分为正负两种。如图4所示。从P+重掺杂到N轻掺杂半导体面积不断减小,称之为正斜表面,反之为负斜表面。正斜表面可使表面最大电场强度随着正斜面角度的増大而减小。
PN结两边的耗尽层在任何偏压下都必然会自动调整满足总体电中性要求。N+区耗尽层的正电荷产生的电力线将全部终止在P+区耗尽层的负电荷上,在正斜表面的情况下,电力线密度随着穿进P区的距离而下降的程度比正交情形慢,因为电力线除了不断被终止于P区负电荷外,由于面积不断增加,电力线同时不断的发散,这就造成电场在P区衰减比正交时更为缓慢。
由于电场下的面积代表了电压,不会变化,现在电场既然变化慢了,电场终止的距高又增加,所以最大电场变小。同理,可以解释负斜表面使最大电场强度增大的原因。
现在可以知道采用结终端斜面化或腐蚀技术可以有效降低电场强度,提高击穿电压。如果再结合表面钝化工艺,一般击穿就不会发生在表面上了。
4. 结终端扩展(JTE)
如图5所示,这种结构最早由Temple提出,其通过控制表面电场,提高雪崩击穿电压。以后提出的P-π-N-N+结构、RESURF结构和横向变化掺杂技术在原理和工艺上与结终端扩展技术大同小异。
这种技术最初是在PN结的一定区域内注入薄层杂质,这样PN结就在器件表面扩展,结终端扩展的名字也由此而来。这种结构对采用平面工艺制造的平面结终端器件作用不大,原因是注入区域太薄,无法有效改善结构弯曲处的电场分布。
如果结终端扩散区的深度大于或等于主结的结深,会有效改善结构弯曲处的电场分布,也会明显地改善PN结的击穿特性。
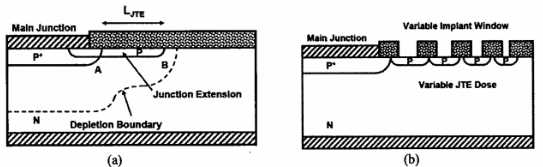
图5 (a)结终端扩展结构;(b)横向变化掺杂结构
实践证明,利用结终端扩展技术可以用较小的终端面积(相对于场限环)获得较高的平面结击穿电压。但是,这项技术也有明显的弱点不管是结终端扩展,还是横向变化掺杂技术,亦或是P-π-N-N+结构和RESURF结构,从实际结构看它们都增加了PN结面积,所以反向漏电流和结电容会增大,与场限环技术一样,它对于界面电荷也是非常敏感的,同时这一技术制造工艺比较复杂,这不利于大规模生产。5. 表面钝化
若表面缺陷如位错以及钠离子和钾离子的污染,就会引起表面的漏电流和最大电场强度的增大,最终导致器件击穿电压的下降。可以采用表面钝化工艺改善这些不利的情况。半绝缘多晶硅薄膜(semi-insulating polycrystalline silicon简称SIPOS)和氮化硅(SiN)或氮化硅薄膜可以有效的控制杂质离子的扩散。
讨论了各种终端技术后,应该知道除了击穿电压外,采用哪种终端技术决定于许多因素。首先,器件的尺寸,对于小尺寸的器件,斜表面的技术就不是适合的方法,最常用的是场限环,可以达到平行平面击穿电压的80%;其次,若在一片晶圆(wafer)上就是一个器件的大尺寸器件,则斜表面技术就可能最好,因为它几乎可以达到理想的击穿电压,而且表面电场强度降低很多,对表面钝化的要求也可放宽,对大多数整流器比较适合。
上一篇:高压大功率快恢复二极管静态特性及设计依据
下一篇:快恢复二极管的反向偏置技术


