一种高电压快恢复二极管的设计与制造
作者:海飞乐技术 时间:2018-11-28 17:26
随着电力电子技术的发展,功率半导体器件的研究和发展,功率半导体器件成为一个重要的独立器件,由于功率半导体器件的研究和发展,电力电子技术朝着大容量、高频化、高效节能、高可靠和低成本的方向发展,高性能的半导体器件主要有以下的特点:大的导通容量、高的阻断电压及高的功率;低的导通电阻及导通电压,即低的导通功耗;更快的开关速度,降低开关损耗。
本文介绍一种高电压的快恢复(FRD)二极管,该二极管具有快的开关速度、低的反向漏电流和软恢复的优点,在原先低电压快恢复二极管的的基础上优化设计、制造工艺、提高综合性能,制造一种具有高性能的高电压快恢复二极管。
1. 高压大功率FRD击穿原理介绍
快恢复二极管(简称FRD)是一种具有开关特性好、反向恢复时间短特点的半导体二极管,主要应用于开关电源、PWM脉宽调制器、变频器等电子电路中,作为高频整流二极管、续流二极管或阻尼二极管使用。快恢复二极管的内部结构与普通PN结二极管不同,它属于PIN结型二极管,即在p型硅材料与N型硅材料中间增加了基区I , 构成PIN硅片。因基区很薄,反向恢复电荷很小,所以快恢复二极管的反向恢复时间较短,正向压降较低,反向击穿电压(耐压值)较高。二极管在高电压反向偏置下,PN结就产生击穿并有大的电流通过,有两种击穿方式:a. 隧道击穿,是指电场强到将共价键束缚的电子释放出来,产生两种载流子一电子和空穴;b. 雪崩击穿,自由载流子在两次碰撞之间从电场获得足够的能量,与晶格放生碰撞时可以打破共价键是束缚,产生电子空穴对。
2. 高压大功率FRD重要参数
2.1反向恢复时间:二极管在正向导通时,漂移区会有大量的自由载流子,使得正向压降VF很低,从正向导通到反向截至状态时,必须从漂移区抽取这些高浓度自由载流子,以保证漂移区能够承受高电场强度,过程中需要的时间即为反向恢复时间。
2.2反向恢复软度:S=Tb/Ta,通常S越大,意味反向恢复时间越小,软度反映在反向恢复的动态,软度因子与少子寿命控制方法、基区宽度和扩散浓度分布、元件结构及结构参数有关。
场板技术:把金属条或低阻多晶硅条扩展到结外N区的上方,当器件的主结加反向电偏电压时,由于场板相对于N区为负电位,抵消了SiO2层中的正电荷对N区表面的影响,排斥表面电子,使表面耗尽区扩展得比体内更宽,改善了表面击穿特性,提高了击穿电压。
表面钝化:表面缺陷如位错及钠离子和钾离子的污染,会引起表面漏电流和最大电场增大,导致器件击穿电压降低和可靠性降低,表面钝化技术可以有效的控制杂质离子的扩散。
结终端技术:场限环。
本文介绍一种高电压的快恢复(FRD)二极管,该二极管具有快的开关速度、低的反向漏电流和软恢复的优点,在原先低电压快恢复二极管的的基础上优化设计、制造工艺、提高综合性能,制造一种具有高性能的高电压快恢复二极管。
1. 高压大功率FRD击穿原理介绍
快恢复二极管(简称FRD)是一种具有开关特性好、反向恢复时间短特点的半导体二极管,主要应用于开关电源、PWM脉宽调制器、变频器等电子电路中,作为高频整流二极管、续流二极管或阻尼二极管使用。快恢复二极管的内部结构与普通PN结二极管不同,它属于PIN结型二极管,即在p型硅材料与N型硅材料中间增加了基区I , 构成PIN硅片。因基区很薄,反向恢复电荷很小,所以快恢复二极管的反向恢复时间较短,正向压降较低,反向击穿电压(耐压值)较高。二极管在高电压反向偏置下,PN结就产生击穿并有大的电流通过,有两种击穿方式:a. 隧道击穿,是指电场强到将共价键束缚的电子释放出来,产生两种载流子一电子和空穴;b. 雪崩击穿,自由载流子在两次碰撞之间从电场获得足够的能量,与晶格放生碰撞时可以打破共价键是束缚,产生电子空穴对。
2. 高压大功率FRD重要参数
2.1反向恢复时间:二极管在正向导通时,漂移区会有大量的自由载流子,使得正向压降VF很低,从正向导通到反向截至状态时,必须从漂移区抽取这些高浓度自由载流子,以保证漂移区能够承受高电场强度,过程中需要的时间即为反向恢复时间。
2.2反向恢复软度:S=Tb/Ta,通常S越大,意味反向恢复时间越小,软度反映在反向恢复的动态,软度因子与少子寿命控制方法、基区宽度和扩散浓度分布、元件结构及结构参数有关。
场板技术:把金属条或低阻多晶硅条扩展到结外N区的上方,当器件的主结加反向电偏电压时,由于场板相对于N区为负电位,抵消了SiO2层中的正电荷对N区表面的影响,排斥表面电子,使表面耗尽区扩展得比体内更宽,改善了表面击穿特性,提高了击穿电压。
表面钝化:表面缺陷如位错及钠离子和钾离子的污染,会引起表面漏电流和最大电场增大,导致器件击穿电压降低和可靠性降低,表面钝化技术可以有效的控制杂质离子的扩散。
结终端技术:场限环。
表1 反向恢复参数说明表

3. 版图设计
芯片结构:硅功率二极管P-N结几何形状和半导体表面电场对击穿电压的影响十分显著。由于棱角电场和表面电场对击穿电压的不利影响,高压二极管一般不采用平面结构而常用台面结构。台面结构二极管P-N结几何形状可以是正方形、正六边形、圆形等不同的图形。正六边形为120。钝角;
采用台面结构,槽深大于100微米,满足1200V高压要求及玻璃封装的要求;
为降低热阻,减小正向压降,芯片采用六边形结构;芯片表面钝化层满足高温冶金焊接工艺和高压低漏电要求;
利用铂掺杂技术,控制载流子寿命,满足反向快恢复的要求(图1)。
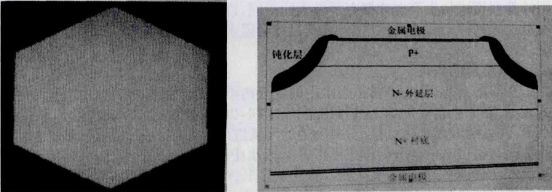
图1
3.1 工艺流程设计
在低电压FRD的工艺流程基础上,优化工艺,确定了图2的工艺流程。

图2
3.2 关键工艺
3.2.1 外延材料的选择:通过仿真工具仿真结果,采用厚度100 µm左右、掺杂浓度1014cm-2,量级的N<1111>Si外延材料。
3.2.2 场板技术:场板使提高平面结击穿电压的一种很有效的办法,场板、绝缘层和半导体构成了MIS结构,当把金属条或低阻多晶硅条扩展到结外N区的上方,当器件的主结加反偏电压时,场板相对于N区为负电位,抵消了SiO2层中的正电荷对N区表面的影响,并排斥表面电子,使表面耗尽层扩展得比体内更宽,改善了表面击穿特性,提高了边缘击穿电压。场板作用的大小与场板下氧化层厚度密度相关。场板长度增加时,电场集中区逐渐移向场板边缘。场板愈长,结处电场愈小,场板下氧化层愈薄,电场向场板方向转移愈明显,但厚度太小,又会造成场板边缘介质击穿。
3.2.3台面结构优点:在功率可控硅中高压电力半导体器件芯片的制造中,采用台面工艺制造技术结构的优点是击穿电压高,产品可靠性较好。功率二极管P-N结几何形状和半导体表面电场对击穿电压的影响十分显著。由于棱角电场和表面电场对击穿电压的不利影响,高压二极管一般不采用平面结构而常用台面结构。台面结构二极管P-N结几何形状可以是正方形、正六边形、圆形等不同的图形。由于正方形有明显的棱角(90°直角),对提高器件的击穿电压最不利;正六边形为120°钝角台面腐蚀可控深槽腐蚀硅;
深槽台面结构图形形成技术:要求粘附性,曝光显影前后的胶厚比较,经受酸碱浸蚀的能力;
粘度:大,台阶腐蚀能力高;使用负性光刻胶(图3)。
光刻流程优化:通过进行三次的涂胶-曝光-显影之后效果好了很多。

图3
用硅腐液腐蚀,腐蚀槽的深度要求在100um之上,腐蚀速率保持在5um/min左右。为了提高腐蚀后表面的均匀性,采用硅腐蚀液(硝酸;氢氟酸;醋酸),稀释剂使用醋酸,可以抑制硝酸的分解,使醋酸的浓度维持在较高的水平上,对于HF-HNO3混合刻蚀液,当HF的浓度较高而HNO3的浓度低时,Si膜的腐蚀速率由HNO3决定,有足量的HF区溶解反应中的SIO2;而当HF的浓度低而HNO3的浓度高时,Si膜的腐蚀速率由HF决定;
沟槽应适当放宽一点,腐蚀槽深适当加深一点,对提高p-n结表面击穿电压和降低表面漏电流有效。
3.2.4高可靠钝化工艺:若表面缺陷如位错以及钠离子、钾离子的污染,就会引起表面的漏电流和最大电场强度的增大,最终导致器件击穿电压的下降,可采用表面钝化工艺进行改善。
要求:低缺陷复合钝化膜,
热氧化层SiO2—PSG—SIO2;
第一层SiO2层的作用:厚度2000A,作用是降低硅片表面缺陷;
第二层PSG层的作用:厚度3000A降低可动电荷密度;
第三层SiO2层的作用:厚度4000A表面保护层。
通过进行掺氯氧化控制可动电荷和固定电荷(表2)。
表2 钝化膜厚度数据测试

3.2.5 铂蒸发及扩散工艺:提高快恢复速度最有效的办法就是热扩散杂质的方法在硅禁带中引入深能级,如扩铂、扩金等,确保在硅材料中得到均匀的深能级杂质。
铂淀积方式:背面减薄→铂蒸发→铂扩散
圆片减薄后背面采用溅射的方式淀积铂,厚度约为500~800A;扩散工艺为:在温度为900~930℃条件下90~100min扩大重金属铂。器件结深随漂移区掺杂浓度降低而增大,通过优化终端结构和工艺参数的调整来有效的控制铂的补偿作用。
通过试验得出不同温度、不同铂厚度、不同扩铂时间下的trr(nS)参数(图4~6)。
恢复二极管的反向恢复时间与正向压降成指数关系,恢复时间短的器件,正向压降(VF)。


图6 反向恢复时间与VF之间关系
4. 试验结论
采用本文介绍设计的FRD,经实际流片,试制样品的实测结果,击穿电压达到了设计要求,对于陡直,拐点明确,漏电流低于1uA,良品率达到96%以上,击穿电压重复性和一致性很好。对于击穿电压大于1200V的FRD器件设计具有一定的指导作用。
上一篇:二极管制造中的光刻工艺步骤
下一篇:论高压整流二极管在城轨牵引动力系统中的应用


