重离子辐照1200V碳化硅二极管漏电退化的缺陷分析
新一代航天器对高压功率器件提出了迫切的使用需求。第三代半导体材料碳化硅(SiC)因其所具有的宽禁带(Si的2~3倍)、高临界电场(Si的10倍)、高热导率(Si的3倍)等优良的材料特性,在高温高压大功率器件的应用中受到人们的重视。其中,作为高压功率二极管的代表之一,SiC结势垒肖特基二极管具有大电流、高反向偏压、开关速度快、抗浪涌电流强等特点,适合航天电源系统的应用。国内外对SiC结势垒肖特基二极管开展的单粒子试验结果表明,其抗单粒子能力远不如预期。在远低于额定电压的偏置条件下,出现漏电流的增加,甚至发生单粒子烧毁。目前,SiC结势垒肖特基二极管重离子辐照性能退化及单粒子烧毁的机理是当今国际该领域的研究热点。其中,重离子辐照诱生缺陷对漏电流退化的影响是一项重要研究内容。国内外已大量报道关于4H-SiC材料生长和离子注入或电子、离子辐射之后观察到的本征缺陷中心(Z1/Z2,P1/P2,RD1,2,RD3,EH6,7,…)以及掺杂或过渡金属(钒,钛,铬和钪)引起的缺陷中心(ID,ID2,…)。国内外研究结果显示,不同粒子辐照后,SiC二极管的反向漏电特性有所不同。有研究结果表明,4.5MeV电子辐照后,SiC二极管的漏电流保持较低水平且在更高的辐照注量下有所降低。α粒子辐照后4H-SiC二极管的漏电流降低,并且他们认为这是辐照后Z1/Z2中心的浓度增加导致载流子浓度降低的结果。4H-SiC的Z1/Z2中心是硅离子辐照后二极管漏电流增加的主要缺陷。对于重离子辐照试验,国内外已有大量试验结果一致表明,辐照后,SiC二极管的漏电流增加。为了深入研究SiC结势垒肖特基二极管重离子辐照诱生缺陷与漏电流退化之间的关系,文中对1200V SiC JBSD样品开展了重离子辐照试验,并采用深能级瞬态谱对其进行了缺陷分析。
1. 试验
1.1重离子辐照试验
试验样品为国产SiC结势垒肖特基二极管(JBSD),其额定反向工作电压和平均正向电流分别为1200V和8A,样品编号分别为1#和2#。试验样品采用TO封装,无顶盖,芯片裸露,且表面未涂胶。试验样品结构剖面和实物分别如图1和图2所示。
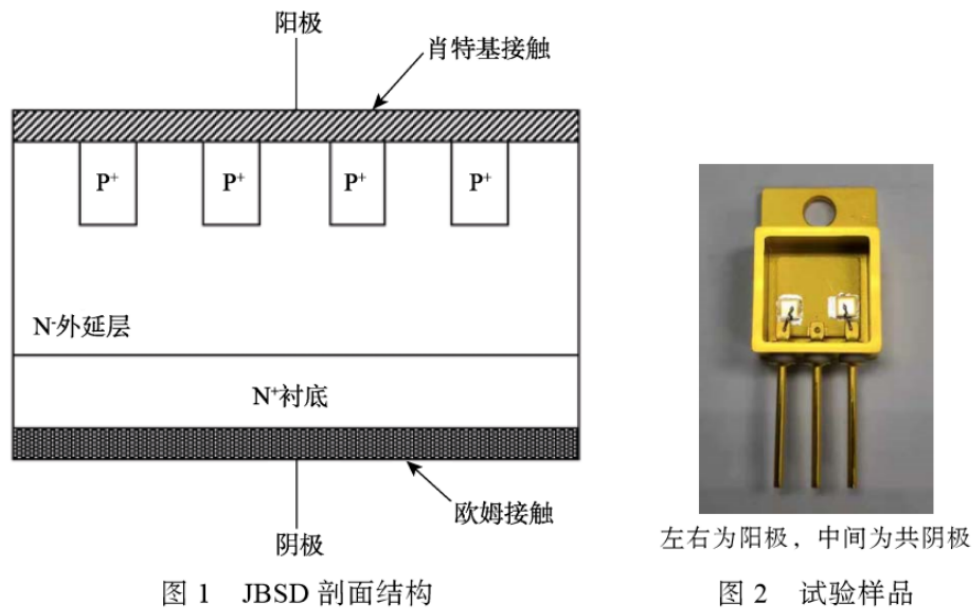

1.2深能级瞬态谱测试
辐照前后分别对1#和2#样品进行深能级瞬态谱测试分析。利用西安电子科技大学的深能级瞬态谱仪Semetrol DLTS对辐照缺陷进行测试,分析SiC JBSD的重离子辐照诱生缺陷情况。试验中选取的DLTS测试条件见表2。
2. 结果及分析
2.1重离子辐照试验结果及分析
锗离子辐照试验结果见表3。锗离子辐照过程中,1#样品在300V反向偏压条件下,漏电流随注量增加而增加。当注量达到1×106cm-2时,停止辐照,此时漏电流在线监测漏电流为10μA。2#样品在400V反向偏压条件下,漏电流随注量增加而增加。当在线监测漏电流达到10μA时,停止辐照,此时注量为9.81×104cm-2。
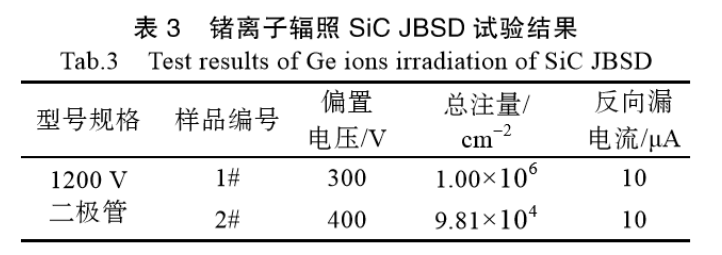
由于肖特基二极管,耗尽层电容可由式(1)表示:

为直观反应内建电势差和载流子浓度的变化情况,给出了2#样品辐照前后,反偏电压0~8V部分的1/C²~VR曲线,如图4所示。可以看出,辐照后1/C²~VR曲线斜率变大,由式(1)可知,载流子浓度变小。辐照后1/C²-VR曲线的横坐标截距变小,即内建电势差变小。


由于肖特基势垒高度可由式(2)给出:

综合式(1)和式(2)可知,辐照后2#样品的势垒高度降低。
2.2 DLTS测试结果及分析
2#和1# SiC JBSD辐照前后的DLTS测试结果对比曲线如图5所示。可以看出,DLTS信号(AC/C)主要呈现出三个峰,依次将其命名为E0.4、Z1/Z2和EH。从图5a中可以看出,辐照后,E0.4能级和Z1/Z2能级基本未发生变化,EH能级有展宽的现象。E0.4和Z1/Z2通常认为是具有特定结构的硅空位和碳空位。分析认为,EH能级的缺陷复杂,推测是两个或多个缺陷能级的叠加(EH4、EH5、EH6、EH7等)。这些缺陷均为受主型缺陷,俘获电子,使载流子浓度降低,与2.1中分析结果一致。分析认为,载流子浓度的变化未对二极管漏电产生影响,此处缺陷的复杂程度与漏电流的退化成正相关。
此外,从图5中可以看出,测试电压VM=-8V,填充脉冲电压VF=-1V条件下测得的EH能级浓度比VF=-4V条件下测得的高。不同DLTS测试条件下的耗尽区分布如图6所示。当DLTS测试条件为VM=-8V,VF=-4V时,测试的耗尽区范围为区域①;当DLTS测试条件为VM=-8V,VF=-1V时,测试的耗尽区范围为区域①和区域②。因此,认为VF=-1V测试条件下测得的EH能级浓度较高是因为大部分EH缺陷位于区域②,这些缺陷的所在位置接近SiC外延层的表面。推断这些位于靠近SiC外延层表面的复杂缺陷是导致SiC二极管漏电退化的原因之一。然而,由于DLTS是测量耗尽区中的电容,反映的是耗尽区中的微观缺陷情况。根据2.1节正反向IV特性测试结果,造成辐照后二极管反向IV特性退化的原因也有可能是辐照过程中金属受损,产生的宏观缺陷等。
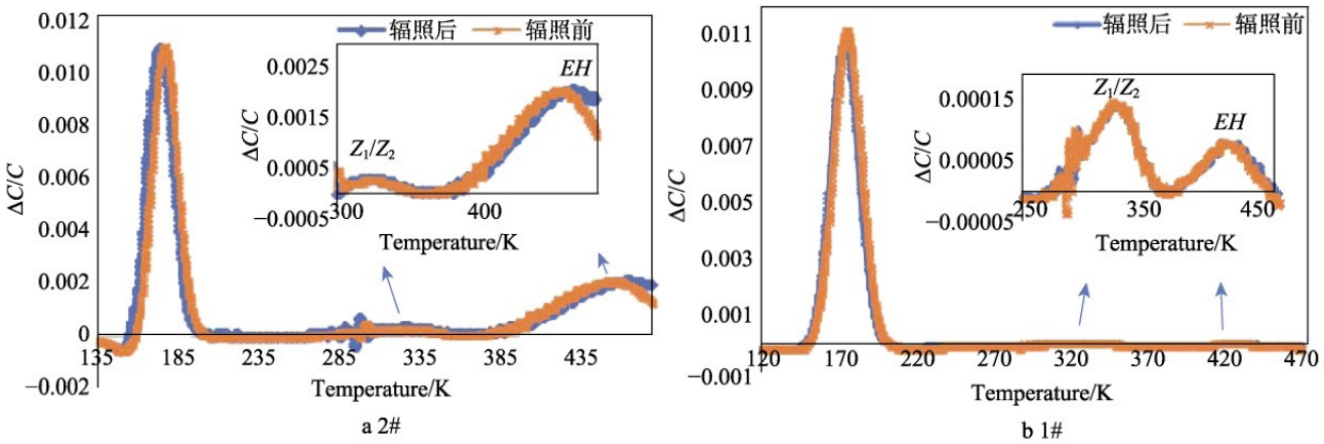
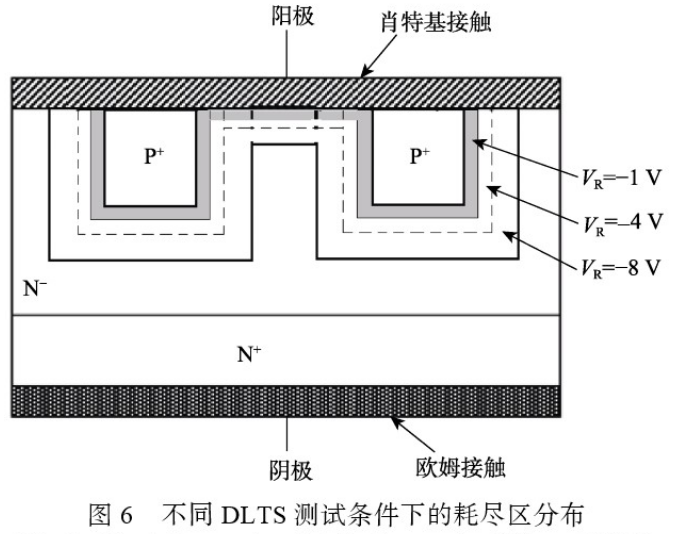
3. 结论
通过对重离子辐照前后1200V碳化硅二极管的电学特性和深能级瞬态谱进行对比分析,可以得到以下结论。
1)重离子辐照后,SiC JBSD反向漏电流退化的原因之一是辐照使二极管的势垒高度降低。
2)重离子辐照后,载流子浓度有所降低,未对漏电流退化产生影响。
3)重离子辐照后,SiC JBSD反向漏电流的退化与EH缺陷的复杂程度成正相关。
4)EH缺陷的所在位置接近SiC外延层表面,推断这些靠近SiC外延层表面的复杂缺陷是导致SiC二极管漏电退化的原因之一。
5)DLTS测量的是耗尽区中的电容,反映耗尽区中的微观缺陷情况,造成二极管反向IV特性退化的原因可能是辐照过程中金属受损,产生的宏观缺陷等。
上一篇:IRFP4868PBF现货参数应用及PDF资料下载
下一篇:具有场限环终端的6500V 4H-SiC结势垒肖特基二极管


