SiC肖特基二极管的反向特性技术
开关器件是最基本的半导体器件之一,其正向开启电压、反向阻断电压以及开关特性是几项主要的性能指标。常见的开关速度较快的硅基肖特基势垒二极管(SBD)开关时间在10ns以内,但是反向工作电压在100V以内,难以实现高电压快速转换工作。一般整流二极管反向恢复时间过长,快恢复二极管、超快恢复二极管的反向工作电压可以达到300~600V,但是正向导通电阻过大,电路转换损耗大,反向阻断电压过低,不能够实现某些高频转换以及高压电路工作,而SiC基SBD整流管反向阻断电压可以高达数千伏,反向恢复时间只有几纳秒,正向电流密度较大,国际上已经有货架产品,工作效率高,因此具有很大的研究价值。
宽禁带材料以及器件一直是近年来半导体领域研究的重点。其中,SiC材料禁带具有宽度宽、雪崩击穿电场强度大、导热率高、物理、化学性能稳定等优点,SiC器件可以在高电压下工作,功率密度大,可靠性好。宽禁带材料中只有SiC材料有4英寸(100mm)单晶体衬底商品供应。因此,SiC器件是最有可能在近期获得广泛使用的宽禁带器件。SiC材料虽然具有较高的雪崩击穿电场强度,但是由于表面电场集中,在远低于按照体材料雪崩击穿电场强度设计的工作电压下就会发生表面击穿,引起器件失效。为了避免这种情况,一般都采用终端结构缓解表面电场集中。本文制备了简单结构SBD以及带有FP、FLR和FP+FLR等不同终端结构的SBD,比较了不同结构对于器件反向特性的影响。
1. 器件制备
衬底采用2英寸(50mm)n型4H-SiC单晶衬底,8°偏角,单面抛光。利用CVD设备在此衬底的Si面同质外延了SiC SBD结构材料,结构如表1所示。外延层厚度不均匀性小于5%,n型掺杂浓度不均匀性小于5%,双晶XRD测试半高宽不超过35arcs。

2. 测试与结果分析
采用QT2半导体特性图示仪测试了所制备芯片的反向阻断电压,Keithley4200半导体特性图示仪测试较低反向电压下的反向泄漏电流。本文中除非特殊说明,反向阻断电压都是以10μA反向泄漏电流下的反向电压为准。为了排除工艺因素变化的影响,反向阻断电压的数值都采用30个单元的平均值。
2.1 反向特性测试
对于30个单元的不同结构器件的最高反向阻断电压见表2。采用FLR结构之后,反向阻断电压有了提高,并且达到90%最高测试电压的比例有了大幅度提高。这是由于采用FLR结构之后,金属电极与半导体界面的接触区域电场峰值减弱。
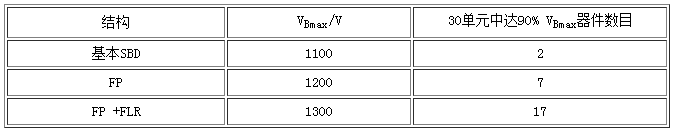
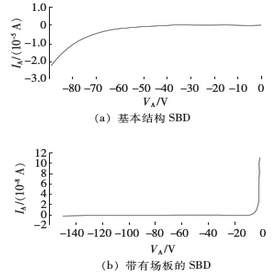
在测试反向阻断电压可以发现,随着反向电压的增加,首先在离子注入的场限环外缘局部会发出白色的光斑,反向电压继续增加,光斑逐渐连续,成为围绕着注入外环的圆,场限环结构的宽度越小,发光强度越大(图2)。这说明在场限环结构的边缘,电场强度已经非常高,并且场限环宽度愈小,电场强度越大。

2.2 场板长度以及场氧化层厚度的影响
在其他结构都相同的条件下改变场板长度,分别取为5,10,15,20,25μm。在离子注入面密度以及场氧化层厚度都一致的条件下,对于30个SBD单元的反向阻断电压进行了测试,其结果平均值如图3所示。在实验研究的场板长度变化范围内,反向阻断电压随着场板长度的增加而增加,但是增加的幅度越来越小,这说明最大场板长度已经接近于最优值。
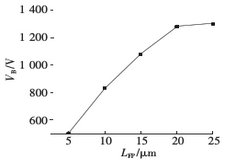
实验中改变场氧化层厚度,分别为200,350,500,650,800nm,并对对应结构的最高反向阻断电压进行了统计。对于FP+FLR结构的器件,场氧化层厚度为350nm时,阻断电压一般低于1000V,厚度为500nm反向阻断电压最高,可以达到1300V,场氧化层厚度为650nm,反向阻断电压又稍有降低,反向阻断电压为1000V左右,场氧化层厚度为800nm,反向阻断电压一般在800V左右。实验中外延层经过离子注入以及氧化之后,n型外延层有效厚度9.2μm,依本文结果,场氧化层厚度应该为外延层厚度的1/20左右为优。
2.3 注入外环(犉犔犚)结构变化的影响
电极外FLR结构主要变化了注入环的宽度以及注入区域电荷面密度。其他条件不变,主要变化了FLR注入环的宽度,分别为20,40,50,60,70μm,相应的反向阻断电压的变化趋势见图4。可见,反向阻断电压随着注入环宽度的增加而增加,但是到了60μm之后增速比较慢,说明注入环的宽度已经接近理想的最大宽度。这与前述发光环的出现是一致的。
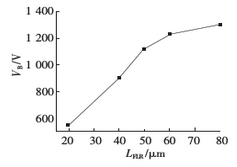
注入电荷的剂量对于阻断电压的影响比较大。按照75%最优FLR电荷密度进行注入的样品,不如按照150%最优FLR电荷密度进行注入的样品的反向阻断电压高,这与一般Pin结二极管的结果不相同。在一般的Pin结二极管中,理想FLR电荷数量的60%~80%往往更有助于得到最高的反向阻断电压。本文中的结果却是相对高的注入剂量有助于得到高的反向工作电压,研究了采用犆犞测试仪排除了离子注入激活率误差的影响,原因可能是SBD与Pin二极管结构不同,SBD器件表面不完全是P型区域,由此需要更多剂量的电荷才能得到与Pin结结构相同的电场分布。采用FP+FLR结构的器件中,场板氧化层厚度为500nm时,场板长度分别为20μm和25μm的器件,10μA反向泄漏电流下最高反向阻断电压均可以达到1300V,并从表2中可以看出,器件可以达到高反向击穿电压的比例也较大,反向阻断电压对于FP的长度不再敏感,所以FP+FLR结构是一种更加合理的结构。
3. 结论
制备了反向阻断电压超过1300V的SiCSBD。采用FP结构、FLR结构都有利于提高反向阻断电压,降低反向泄漏电流,FP+FLR结构是一种更加合理的结构。在实验所采用结构变化范围内,反向阻断电压随着FLR长度的增加而增加。场氧化层厚度为外延层厚度的1/20可以得到较大的反向阻断电压。场板结构中相对较高的注入离子面密度有助于提高反向阻断电压。
上一篇:肖特基二极管中磁场超快产生的技术研究
下一篇:沟槽型SBD肖特基二极管工艺设计技术研究


