碳化硅肖特基二极管的正向压降技术
作者:海飞乐技术 时间:2018-05-24 11:41
1. 正向压降的优化
考虑所有的寄生电阻,肖特基二极管的正向压降实际上可以表示为
 (1)
(1)对于高压碳化硅肖特基二极管,优化漂移区电阻是减小正向压降的关键。两个重要的参数漂移区掺杂浓度和厚度,决定了器件的阻断能力和比导通电阻。对于这两个参数有一个折中关系,高电压阻断能力需要厚的、低掺杂漂移层,而获得低的比导通电阻要求恰好相反。漂移区的选取要求满足所需阻断电压,使有效终端的厚度最小,漂移区浓度最大。n型碳化硅肖特基二极管漂移区的比导通电阻可以表示为
 (2)
(2)对于穿通型结构,漂移区厚度可以表示为
 (3)
(3) (4)
(4)图1给出了当给定的阻断电压为1200V时,漂移层的厚度和比导通电阻与漂移层浓度的关系曲线。图1中假设SBD的边缘终端效率可以得到80%的理想平行平面击穿电压。从图中可以得出对于优化设计,穿通型(PT)结构的漂移区掺杂浓度为非穿通型(NPT)结构的90%,厚度为NPT的87%,获得的比导通电阻比NPT小7%。
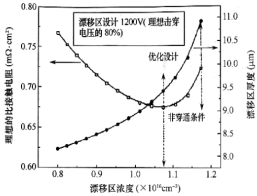
图1 击穿电压为1200V时,漂移层的厚度和比导通电阻与漂移层浓度的关系曲线,假定边缘终端效率为80%,这表明在90% NPT掺杂和87%漂移层厚度时可以得到最佳设计
SIC单极功率器件比导通电阻的理论极限比Si单极功率器件小2~3个数量级。图2给出了实验证明的SIC二极管的最小比导通电阻随击穿电压的变化关系。

图2 SBD比导通电阻随击穿电压的变化
 (5)
(5)2. 正向压降的温度系数
不同温度条件下SBD(或JBS、MPS)正向压降的变化可以通过方程(1)所示的三部分决定。在实际工作的电流密度范围内,对于给定的电流密度,方程的第一部分是负值,并随温度升高而降低。方程的第二部分,即势垒高度分布也是随温度升高而减小。第三部分是漂移区、衬底区,以及欧姆接触电阻对正向压降的贡献。对于具有低阻衬底和良好阴极(p型SBD为阳极)欧姆接触的SBD,漂移区电阻占主要部分,随着温度升高,迁移率退化,漂移区电阻不断增加。
因此,SBD正向压降总的温度系数与方程(1)中三部分随温度的相对大小有关。当电流密度很低时,方程中的前两部分起主要作用,VF的温度系数为负值。对于实际工作的电流密度,如1~500A/cm2,由于前两项与电压呈指数关系,相对保持不变。然而,第三部分的电阻项与电流密度呈线性关系,而且在高电流密度时占主要部分。因此,当电流密度达到一定值时,器件总的正向压降的温度系数将由负值变为正值。图3给出了具有相对低阻断能力的SBD(1.2~1.4×1016cm-3、4μm)在不同电流密度时,正向压降随温度的变化关系。当电流密度约为300A/cm2时,VF的温度系数变为正值。对于具有低掺杂、厚漂移区的碳化硅肖特基二极管(决定了高阻断电压),电阻项对于VF的作用将更大,VF的温度系数在低电流密度时为正值。
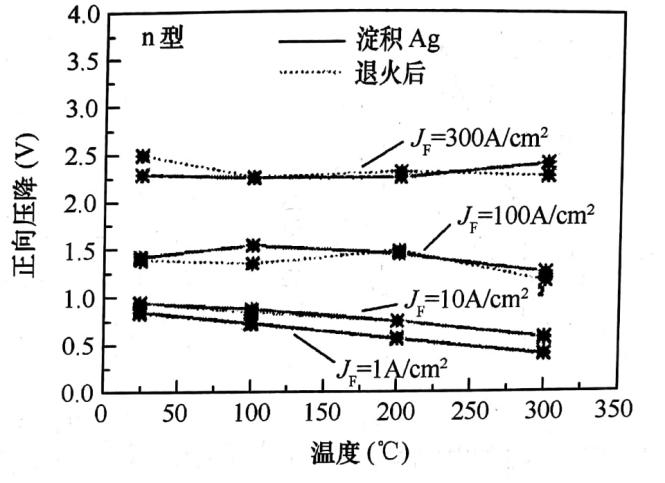
图3 不同电流密度时SBD正向压降随温度的变化
其他人还看了
碳化硅二极管的反向漏电流技术
碳化硅肖特基二极管与快恢复二极管对比
碳化硅肖特基二极管的静态特性及应用
上一篇:功率二极管的重要性与硅极限
下一篇:PN结大功率整流二极管工作原理及反向恢复特性


