碳化硅肖特基二极管的电荷收集特性
碳化硅(SiC)具有禁带宽度大、击穿电场强度高、饱和电子漂移速度高、热导率大、介电常数小、抗辐射能力强、化学稳定性良好等特点,被认为是制作高温、高频、大功率和抗辐射器件极具潜力的宽带隙半导体材料。相比于传统硅基半导体探测器具有优异的耐高温和抗辐照性能,近年来SiC材料在核探测领域得到了广泛的关注,被应用于致电离粒子(X射线、γ射线、a粒子等)和中子探测等方面。国内在SiC应用于核探测方面的研究起步较晚,主要集中于辐照效应研究、高温特性研究及少量的探测器模拟研究,而在SiC器件应用于核辐射探测方面的实验研究鲜有报道。值得指出的是,SiC器件的电荷收集特性对探测器性能具有重要影响,而国内针对该类核探测器的电荷收集特性开展的研究甚少。为进一步研究SiC肖特基二极管作为核探测器的性能,本文采用4H-SiC制备肖特基二极管,利用Am源研究其对a粒子的电荷收集特性,分析电荷收集率(CCE)的影响因素。
1. 器件结构及实验方法
1.1肖特基二极管结构
4H-SiC肖特基二极管的横截面如图1(a)所示。4H-SiC晶片基底厚度为360µm,低掺杂外延层厚度为13µm,经高频CV测试获得外延层净掺杂数密度Nd为 。外延层与晶片基底之间缓冲层的厚度为1µm。在4H-SiC晶片基底表面溅射1µm的Ni并退火形成欧姆接触,并电镀6µm的Au作金属加厚层,SiC外延层表面溅射0.1µm的Ni形成肖特基接触。
。外延层与晶片基底之间缓冲层的厚度为1µm。在4H-SiC晶片基底表面溅射1µm的Ni并退火形成欧姆接触,并电镀6µm的Au作金属加厚层,SiC外延层表面溅射0.1µm的Ni形成肖特基接触。

1.2性能表征
1.2.1电流-电压、电容-电压测量
正向电流-电压(IF-V)曲线采用Agilent 4155C半导体特性分析仪进行测量,测试电压范围为:0~2V。反向电流-电压(IR-V)曲线采用Keithley 6517B进行测量,测试电压范围为:0~700V。电容-电压(C-V)曲线采用Agilent 4155C与Agilent 4284A组成CV测试系统进行测量,测量频率为1mHz,测试电压范围为0~10V,在室温及黑暗条件下进行测量。
1.2.2电荷收集效率测量
CCE的定义为

式中:Q0是粒子在探测器中产生的总电荷量;QM是探测器所探测到的电荷量。4H-SiC肖特基二极管CCE实验测量采用与同条件下Au-Si面垒型探测器进行脉冲幅度归一化的方法,测量装置示意图如图2所示。探测器和Am源置于金属屏蔽盒内。241Am源放出的a粒子经过19.6mm的空气间隙后进入探测器,在探测器灵敏区(对SiC探测器,灵敏区为反偏电压下外延层内所形成的耗尽区)产生电子空穴对,并在电场作用下分别向两极漂移,形成正比于能量沉积的电信号,经电荷灵敏前置放大器和线性放大器处理,用多道分析器采集分析即得脉冲幅度谱。其中,19.6mm空气间隙的选取是为使a粒子可完全被阻止在4H-SiC外延层中。采用SRIM2011程序可计算出Am源放出的a粒子经19.6mm空气间隙及0.1µm金属Ni层后剩余动能Ea为3.5mEV,在SiC中的射程为(9.6±0.3)µm。在放射源与后端电子学系统不变的情况下,分别使用Au-Si面垒型探测器与4H-SiC肖特基二极管进行测量。当Au-Si面垒型探测器的电荷收集效率SSi=1时,4H-SiC肖特基二极管的电荷收集效率SSiC可表示

式中:PSiC,PSi分别是4H-SiC肖特基二极管与Au-Si面垒型探测器所测得的a能谱峰位;ɛSiC和ɛSi分别是4H-SiC与Si中产生一对电子空穴对所需的平均能量,分别取7.8eV和3.67eV。
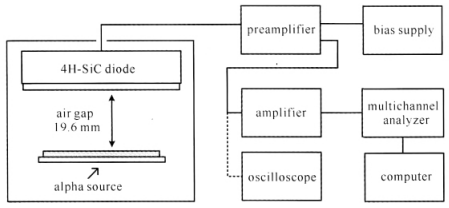
2. 实验结果与分析
2.1电流-电压与电容-电压
本次实验制备的4H-SiC外延层属中等掺杂浓度的高迁移率半导体,该二极管小电压时的电流特性可描述如下

式中:A*为热电子发射的有效理查逊常数;T为温度;q为电子电量;k为玻耳兹曼常数;η为理想因子;V为外加电压;ΨB为4H-SiC二极管的肖特基势垒高度。利用式(3),从图3所示的IF-V曲线得出ΨB和η。其中ΨB=1.66eV,理想因子η为1.07,表明其电流输运机制主要为热电子发射过程。

图4是4H-SiC肖特基二极管的IR-V特性。从图4可见,在反向偏压高达700V时,该二极管未击穿,其漏电流仅为21nA。该二极管具有高击穿电压表明4H-SiC在强电场下的电离率较低,而电离率低得益于4H-SiC较大的禁带宽度(3.26EV)。图5是4H-SiC肖特基二极管C-V特性。1/C2-V曲线经线性拟合后相关系数好于0.999,表明掺杂数密度随深度分布均匀。由该曲线斜率可求得4H-SiC外延层金属-半导体界面附近的净掺杂数密度Nd
 。
。
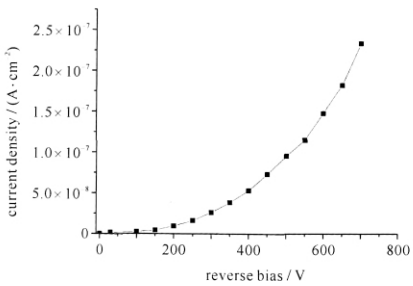
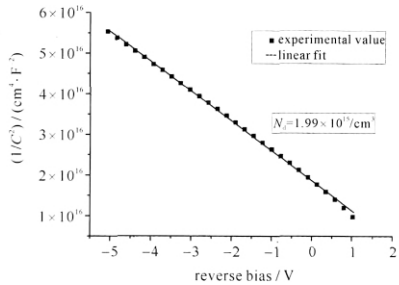
2.2 电荷收集率与电压的关系
图6是实验测得4H-SiC肖特基二极管CCE与反向电压关系。从图6可见,当外加偏压为0V时,对3.5MeV a粒子的S为48.7%;当外加偏压为150V时即有S为99.4%,表明所制备的4H-SiC肖特基二极管具备良好的电荷收集特性。
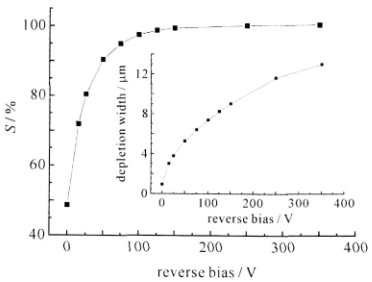
当电压值较小时,入射粒子射程值R介于耗尽区宽度W和外延层厚度H之间(即W<R<H),考虑耗尽区载流子漂移过程及中性区载流子扩散过程,CCE可表示为

式中:ξ(x)是x处产生的电荷最终被收集的概率;Lp为空穴扩散长度;(-dE/dx)为电子阻止本领;E为入射粒子能量。假设掺杂数密度分布均匀,则耗尽区宽度W与反偏电压V关系如下

式中:ψbi为肖特基势垒的内建电势,据前述I-V测试结果可取ψbi=1.66V;Nd为外延层净掺杂数密度,据前述C-V测试结果取Nd为
 ;εs和q分别为4H-SiC介电常数和电子电量。由式(4),(5)可知,当电压值较小时,耗尽区宽度随电压上升而增大,从而电荷收集率SSiC随之上升。
;εs和q分别为4H-SiC介电常数和电子电量。由式(4),(5)可知,当电压值较小时,耗尽区宽度随电压上升而增大,从而电荷收集率SSiC随之上升。在较高电压下有W>R,则CCE可表示为

式中若载流子平均寿命大于漂移时间,可认为ξ(x)=1。从而对所有V>V0,(V0为W=R时对应的反偏电压值)有SSiC为100%。由式(5)可求得V0=170V,即反偏电压在170V后,对3.5MeV的a粒子,CCE保持100%不变,与图(6)所示趋势吻合。
3. 结论
采用耐高温、抗辐照的宽带隙半导体材料4H-SiC制成肖特基二极管,利用241Am源的a粒子研究了该二极管电荷收集特性。该4H-SiC二极管的肖特基势垒高度ΨB为1.66eV,理想因子η为1.07。在反向偏压高达700V时,该二极管未击穿,其漏电流仅为21nA,具有较高的击穿电压。对3.5MeV a粒子,0V时CCE为48.7%,150V时CCE为99.4%,表现出良好的电荷收集特性;CCE随外加反向偏压的增大而升高,在170V后趋于饱和,该现象可结合载流子的扩散-漂移过程加以解释。
4H-SiC具有良好的电荷收集特性和优异的耐高温抗辐照性能,适于制备新一代的半导体探测器,可克服常见的硅基半导体探测器不耐高温和抗辐照能力差的缺点,在高温强辐射场等极端环境下具有良好的应用前景。
上一篇:碳化硅PiN二极管正向电压及正反向电流特性
下一篇:一种新型SiC SBD的高温反向恢复特性


