一种新型SiC SBD的高温反向恢复特性
相比于Si半导体材料,SiC半导体材料具有禁带宽度较大、临界电场较大、热导率较高的特点,SiC半导体器件具有导通电阻小、阻断电压高、耐高温耐高压等优点。随着SiC基半导体工艺的成熟,SiC成为工作于较高环境温度和较大功率场合下的首选宽禁带半导体材料。
近年来随着电力电子技术在电动汽车、风力发电、柔性输电等新能源领域中应用的不断扩展,现代社会对电力电子变换器的效率和功率密度提出了更高的要求,需要器件在较高温度环境时仍具有更优越的开关性能以及更小的结温和结温波动。
SiC肖特基势垒二极管(SBD)在高频、高温、高功率及恶劣环境仍能正常工作,且具有良好的开关性能,在上述领域中有巨大的潜力。如在航空静止变流器中,作为前级变换器的桥式逆变器的副边采用SiC SBD,高温环境下仍然保持良好的反向恢复特性,能够提高高温环境下功率系统的效率。SiC SBD在常温下显示出优于Si基快速恢复二极管的动态特性:反向恢复时间短,反向恢复电流峰值小。为了充分发挥SiC SBD在高温下工作的优势,改进系统的稳定性和效率,研究SiC SBD在高温条件下的反向恢复特性有着十分重要的意义。
本文制作了具有场限环结终端和Ti肖特基接触的1.2kV/30A SiC SBD器件,TOP3封装。基于双开关模拟双脉冲控制信号的实验电路,研究了100~300℃时该SiC SBD的反向恢复特性,着重讨论了高温下SiC SBD在反向恢复过程中能量损耗的物理成因。
1. 双开关模拟双脉冲控制的实验电路
通常使用高功率脉冲发生电路来实现对SBD反向恢复特性的测试。但由于脉冲发生电路中的电感元件放电时间仅为微秒级别,因此受脉冲信号上升时间与下降时间的影响较大,较难保证在电感放电结束之前完成开关态的切换。
本文提出了一种双开关模拟双脉冲控制信号来测试SiC SBD的反向恢复特性,测试电路如图1(a)所示。实验采用两路独立的方波信号V1和V2作为开关控制信号,频率均设置为10kHz,幅值为10V,以保证MOSFET(M1,M2)在控制信号作用下可以完全开启。波形时序示意图如图1(b)所示,图中VD为SiC SBD两端的电压,ID为通过SiC SBD的电流。
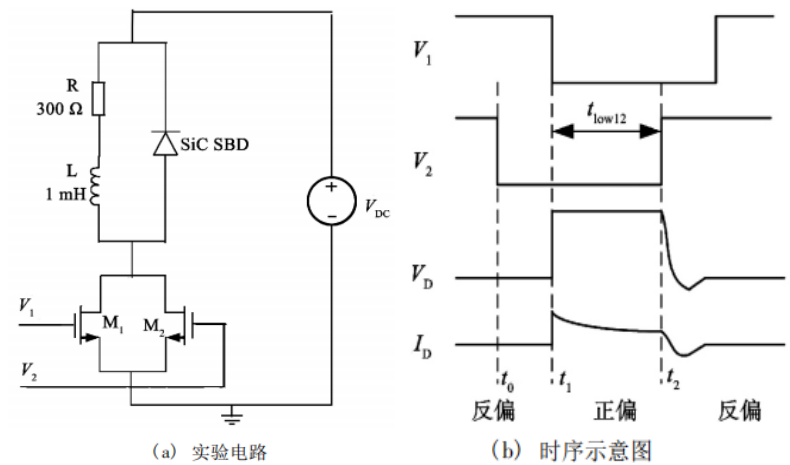
当M1和M2有一个开启或均开启的情况下,由于MOSFET上压降很小,此时VDC电压几乎全部加在SiC SBD两端使二极管反偏。开始阶段M1和M2均开启,SBD反偏,t0时刻关断M2,SBD仍保持反偏。t1时刻再关断M1,由于电感电流需要保持连续,因此形成放电回路使SiC SBD正偏,正偏持续时间由电阻R与电感L构成的一阶RL放电回路决定,时间常数τ为

该测试电路通过调整V1和V2同时处于低电平的时间tlow12来控制正偏电流的大小。以电感L开始放电为t=0时刻,设电阻与电感构成的一阶RL放电回路的瞬时电流为i,则回路的KVL方程为


2. SiC SBD的高温反向动态特性分析
反向恢复特性是评价功率二极管性能的一项重要参数,一般包括二极管两端电压的反向恢复过程,流过二极管电流的反向恢复过程以及二极管反向恢复过程中的能量损耗。在卫星、航空和航天探测等领域实际应用时,其反向恢复特性可能会受到不同反偏电压、环境温度等外部因素的影响,因此,本文采用控制变量法对高温工作环境下的SiC SBD进行分析和研究。本文制作的器件内部结构剖面图与封装前后的器件实物图如图2所示。
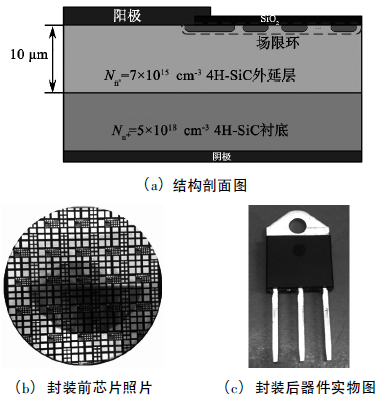
对制备的SBD进行高温反向动态特性测试:
(1)直流电流源提供的直流反偏电压一定时(分别为200,400,600V),不同环境温度(T)下SiC SBD的反向恢复电压(VRR分别如图3所示。
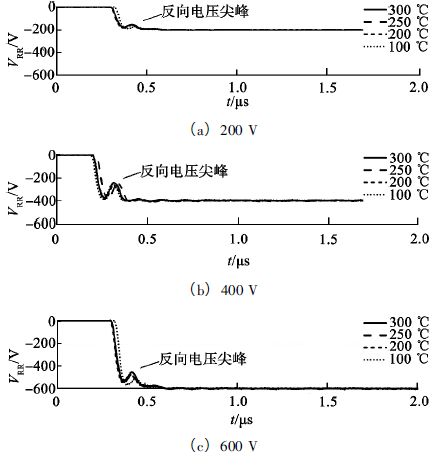
SiC SBD的反向恢复过程中,在一个反向电压尖峰过冲后,其关断才能趋于稳定。这个电压尖峰与SiC SBD的封装、引线、n-掺杂区电导调制效应和寄生电容效应有关。
进一步分析图3中数据,得到SiC SBD在不同温度下的反向电压尖峰值Vs如图4所示。

反偏电压分别为200,400,600V时SiC SBD在100℃时的反向电压尖峰值相对200℃时分别增大了4.70%,1.97%和4.50%;300℃相对200℃时的反向电压尖峰分别增大了6.69%,6.20%和6.85%。
(2)当反偏电压一定时(分别为200,400,600V),不同温度下SBD的反向恢复电流(IRR)如图5所示。
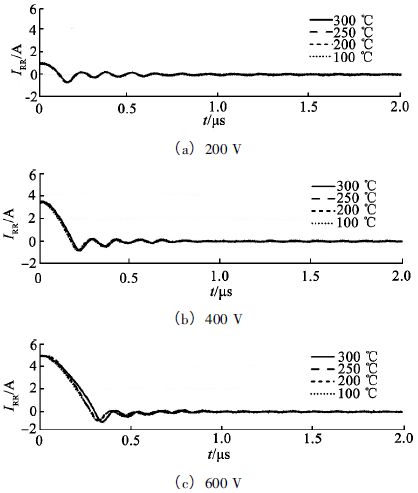
反向恢复电流受温度、直流反偏电压等因素影响不大,反向恢复电流尖峰几乎不变。
对上述反向恢复电流密度J(t)进行积分,即


600V直流反偏电压下SBD中耗尽层电容的积累电荷随着温度的升高而逐渐减小,100~200℃时,反向恢复电荷量减小7.3%,200~300℃时耗尽层电容的电荷量减小21.8%。
3. SiC SBD高温反向恢复过程中的能量损耗
3.1 SiC SBD反向恢复过程中能量损耗的理论模型
半导体与金属接触,金-半界面形成势垒,如图7所示,图中Ec为半导体的导带,Ec为半导体的价带,EF为费米能级,q为电子电荷量。这个势垒影响了SiC SBD的耗尽层电容。
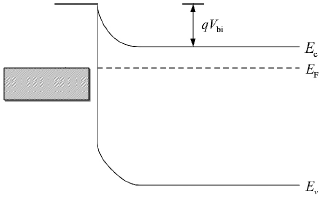
金属与n型掺杂的SiC接触,单位面积的耗尽层电容C'D受到高温环境的约束,定量关系为

影响SiC SBD的反向恢复的过程主要因素是SiC SBD的耗尽层电容。
能量损耗WRR与电荷量的关系为

假定SiC SBD反向恢复过程中的能量损耗WRR来源于耗尽层电容积累电荷的释放,将式(6)代入式(7)得到SiC SBD反向恢复过程中能量损耗的理论表达式为

根据图6的分析,反向恢复电荷Q随着温度的升高而减小。由式(8)可得,总的耗尽层电容CD随着温度的升高而增大;SiC SBD反向恢复过程中能量损耗随着温度的升高呈现下降趋势。
3.2理论模型的实验验证
SiC SBD的反向恢复过程中,反向恢复电压存在反向电压尖峰振荡,而反向恢复电流受到反向恢复时间的限制并不能立刻归零,使得SiC SBD反向恢复损耗功率特性曲线存在功率尖峰现象。由下式可以得到反向恢复损耗功率PRRL为
工作环境温度的升高会使得反向恢复损耗功率特性曲线功率尖峰值变小,SiC SBD反向恢复过程中的损耗功率也随着温度的升高而降低,这与式(8)得出的变化趋势相同。Si基快速恢复二极管的反向损耗功率随着温度的升高而升高,SiC SBD与Si基快速恢复二极管反向恢复功率损耗与温度的关系恰好相反。
由图8可得100~300℃的升温过程中,温度每升高50℃,反向恢复损耗功率尖峰(P)的平均增幅(αP)为-5%。温度升高使得反向电压尖峰增强,反向恢复电流也会随温度细微变化。两个物理量受温度的综合影响较明显,这一点在反向恢复损耗功率尖峰上得以体现。

反向恢复过程中的能量损耗WRR与反向恢复损耗功率的关系为


SiC SBD的反偏电压会影响反向恢复过程中能量损耗对温度的敏感性。反偏电压越大,反向恢复过程中能量损耗对温度越敏感。这一点在高温环境中使用SiC SBD尤为重要。
4. 结论
本文制作了具有场限环结终端和Ti肖特基接触的1.2kV/30A SiC SBD器件,采用双开关模拟双脉冲控制信号的实验电路,研究了该器件在100~300℃高温环境中不同反偏电压下的反向恢复特性,包括:SiC SBD的反向恢复电压、反向恢复电流和反向恢复过程中的能量损耗。实验表明温度每上升100℃,SiC SBD的反向恢复过程中的反向电压尖峰增加5%左右,而SiC SBD的反向恢复电流与反向恢复时间受温度影响不大,该SiC SBD在高温下仍具有优良的开关性能。本文提出了反向恢复过程中的能量损耗的理论模型,实验结果与理论推导基本吻合,验证了能量损耗来源于耗尽层电容积累电荷释放的猜想。SiC SBD反向恢复过程中的损耗功率随着温度的升高而降低,这一点与Si基快速恢复二极管有着本质的不同,在高温环境中使用SiC SBD时应该特别注意,以达到最优效率设计的目的。
上一篇:碳化硅肖特基二极管的电荷收集特性
下一篇:一种新型的耐高温碳化硅超结晶体管


