硅二极管与碳化硅二极管的性能比较
肖特基二极管在导通过程中没有额外载流子的注入和储存,因而基本没有反向恢复电流,其关断过程很快,开关损耗很小。但是对硅而言,由于所有金属与硅的功函数差都不很大,硅的肖特基势垒较低,硅肖特基二极管的反向漏电流偏大,阻断电压较低,只能用于一二百伏的低电压场合。然而,许多金属,例如镍(Ni)、金(Au)、铂(Pt)、钯(Pd)、钛(Ti)、钴(Co)等,都可与碳化硅形成势垒高度1ev以上的肖特基势垒接触。据报道,Au/4H-SIC接触的势垒高度可达1.73eV,Ti/4H-SIC接触的势垒较低,但最高也可到1.1eV。6H-SIC与各种金属接触之间的肖特基势垒高度变化范围较宽,最低只有0.5eV,最高可达1.7eV。于是,肖特基二极管成为人们开发碳化硅电力电子器件首先关注的对象。
美国北卡罗来纳州立大学功率半导体研究中心于1992年报道了世界上首例碳化硅肖特基二极管的研制结果,其阻断电压只有400V,但在他们两年后的报道中,阻断电压提高到1000V,接近其设计值。随后,对碳化硅肖特基二极管的研发活动扩展到欧洲和亚洲,使用材料扩大到4H-SIC,阻断电压也有很大提高。
由于碳化硅材料的临界雪崩击穿电场强度较高,使用功函数差较大的金属制作反向击穿电压超过1000V的碳化硅肖特基二极管应该是比较容易的事情,但为了避免接触边沿附近的表面电场集中,也需要实行终端保护。这通常是用硼离子注入在外延层表面的肖特基接触边沿附近形成一个较浅的pn结,如图1所示。普渡大学的宽禁带半导体器件研究室采用这种方式首先在1997年制成了反向击穿电压超过1500V的碳化硅肖特基二极管。图2是他们分别用Ni和Ti作为肖特基接触材料做成的两种4H-SIC SBD的室温伏安特性测试曲线。这两种器件的外延层参数和终端设计完全相同(杂质浓度为3.5×1015cm-3,厚为13μm;或杂质浓度为1.6×1016cm-3,厚为10μm;终端保护环的硼离子注入量为1×1015cm-2,能量为30keV,注入后在1050℃下退火90min)。由于早期碳化硅材料的晶格缺陷密度较高,这些器件样品的面积都很小,直径在0.1~1.2mm之间,因而其单管电流密度虽然不低,电流并不大。
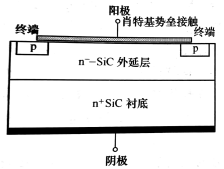
图1 高压SIC 肖特基二极管结构示意图

图2 势垒高度不同的两种4H-SIC 肖特基二极管的伏安特性
由于这两种整流管中为形成肖特基势垒接触所使用的金属不同,二者的势垒高度差别较大。室温下,Ti管和Ni管的势垒高度分别为0.8V和1.3V。势垒高度的不同,导致二者在正、反向特性上的差别甚大。Ni管的雪崩击穿电压较高,其值为1720V,而Ti管只有1480V;Ni管临界雪崩击穿时的反向漏电流密度只有0.1A/cm2,而Ti管临界雪崩击穿时的反向漏电流密度已接近10A/cm2。不仅如此,二者在雪崩击穿之前的相同反向阻断电压下的漏电流密度也相差很大,势垒较高的Ni管的漏电流很小。不过,在相同的正向电流密度下,高势垒肖特基二极管的正向压降也相对较高。
上一篇:肖特基势垒二极管(SBD)的工作原理
下一篇:肖特基势垒高度计算及接触理论


